Intel thử nghiệm làm mát bằng chất lỏng trực tiếp cấp gói (package-level) cho CPU lên tới 1000W
Intel hiện đang thử nghiệm một thiết kế làm mát bằng chất lỏng trực tiếp ở cấp gói (package-level direct liquid cooling) nhằm ứng phó với nhiệt lượng ngày càng cao của các CPU hiệu suất mạnh, đặc biệt trong các tác vụ AI, HPC (High Performance Computing) và máy trạm chuyên nghiệp. Giải pháp này được trình diễn tại sự kiện Foundry Direct Connect với các nguyên mẫu sử dụng cho cả CPU desktop (LGA) và CPU máy chủ (BGA).
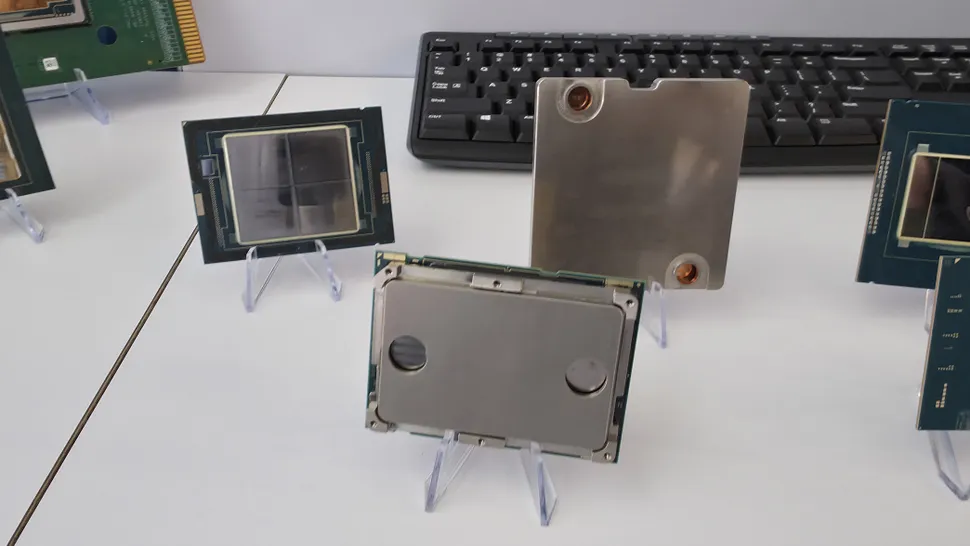
Thiết kế làm mát không đưa chất lỏng trực tiếp lên die (silicon) mà đặt một khối làm mát bằng đồng được thiết kế đặc biệt phía trên package chip. Khối làm mát này được khắc vi kênh (microchannels) để dẫn dòng chất làm mát đi qua các điểm nóng nhất (hotspots) của package, giúp tản nhiệt hiệu quả hơn. Kênh này được bố trí để tối ưu hóa cái gọi là "dịch vụ nhiệt" nơi chip có thể nóng hơn, nhằm nâng cao hiệu suất làm mát nơi nó cần nhất.
Một điểm kỹ thuật đáng chú ý là sự chọn lựa chất dẫn nhiệt tốt: Intel dùng solder hoặc liquid metal làm vật liệu giao tiếp nhiệt (TIM - Thermal Interface Material) thay vì keo dán (polymer-based TIM). Điều này giúp giảm nhiệt trở giữa các lớp truyền nhiệt trong package. Khi so sánh với bộ làm mát nước thông thường gắn bên ngoài, sau khi tháo nắp (delidded) và gắn waterblock trên die trần, giải pháp này được cho là có thể tăng hiệu suất làm mát lên khoảng 15-20%.
Mức công suất mà hệ thống thử nghiệm có thể xử lý lên tới 1.000 watt nhiệt lượng tỏa ra từ CPU, nếu sử dụng chất làm mát bằng chất lỏng tiêu chuẩn. Mặc dù mức này vượt xa nhu cầu của CPU tiêu dùng thông thường, nhưng nó rất phù hợp với các ứng dụng máy chủ, đào tạo mô hình AI lớn và máy trạm chuyên sâu.
Intel chưa xác nhận khi nào hoặc liệu thiết kế này sẽ được sản xuất rộng rãi. Tuy nhiên, prototyping đã tiến triển đủ để cho thấy khả năng ứng dụng thực tế. Trong khi đó cộng đồng người dùng đam mê phần cứng cũng đã thử nghiệm các bản mod tương tự—ví dụ thay đổi heatspreader để làm block nước nhỏ tích hợp kênh bên trong heatspreader, nhằm giảm khoảng nhiệt (thermal resistance).
Việc Intel theo đuổi giải pháp làm mát ở cấp package như này có tiềm năng lớn:
Giảm độ phức tạp của hệ thống làm mát (ví dụ ít bộ phận hơn so với việc gắn block trên die trần)
Giảm kích thước của phần làm mát bên ngoài
Tối ưu hóa khả năng làm mát ở nơi cần nhất để chip giữ hiệu suất cao trong môi trường nhiệt cao









